Атомно-слоевое осаждение оксида гафния (HfO2) — термическое
Оборудование:
Особенности технологии:
атомно-слоевое осаждение (эллипсометр - опционально)
металлический прекурсор: TEMAH
неметаллический прекурсор: пары H2O c контролируемой температурой
доза прекурсора контролируется быстродействующей системой подачи газов
Результаты:
температура осаждения: 200° - 290° C
время цикла <5c, скорость осаждения - 0.8 A/цикл (при дозе насыщения) для 200 мм пластин (время цикла короче для меньших пластин),
10 A/мин, > 60 нм/ч (для 200 мм пластин, быстрее для меньших подложек)
коэффициент преломления 2,0-2,05
Hf:O - 1:2,1
равномерность: +/-3% (по 200 мм)
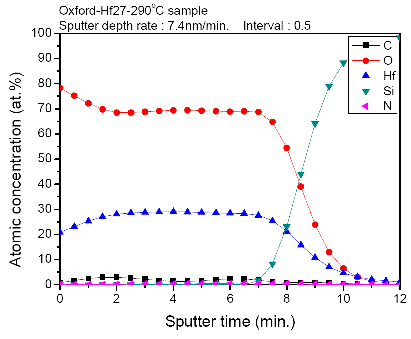
Атомно-слоевое осаждение с воздействием плазмы: Оже-анализ показывает содержание C < 3 %
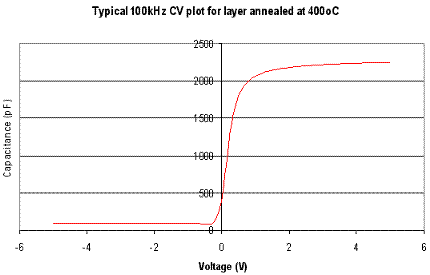
Плотности токов утечки:
< 1x10-9 A/см2 при 2.5 MВ/см для отожженных слоев
> 1x10-7 A/см2 при 2.5 MВ/см для неотожженных слоев
Напряжение электрического поля пробоя больше или равно 3 MВ/см
По накопленной емкости можно оценить k покрытия ~17-18


Зависимость толщины покрытия за цикл от дозы H2O