Атомно-слоевое осаждение оксида гафния (HfO2) с применением удаленного источника плазмы
Оборудование:
- атомно-слоевое осаждение с применением источника индуктивно связанной плазмы (эллипсометр - опционально);
- металлический прекурсор: TEMAH;
- неметаллический прекурсор: O* и O2;
- доза прекурсора контролируется быстродействующей системой подачи газов.

Молекула ТЕМАН (тетроэтилметиламиногафний) - во время процесса необходим нагрев до 70 оС и барботирование
Результаты:
температура осаждения: 200° - 290° C
время цикла <9c, скорость осаждения - 1.1 A/цикл (при дозе насыщения) для 200 мм пластин (время цикла короче для меньших пластин), 7 A/мин, > 45 нм/ч (для 200мм пластин,быстрее для меньших подложек)
 |
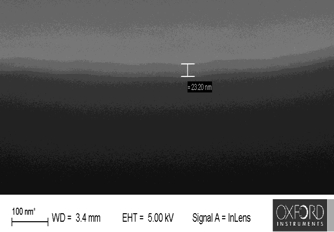 |
|---|---|
| Нижняя и боковая стенка Si тренча с 20 нм HfO2 (шероховатость из-за травления Si Бош-процессом) | Нижняя стенка Si тренча 20 нм HfO2 |
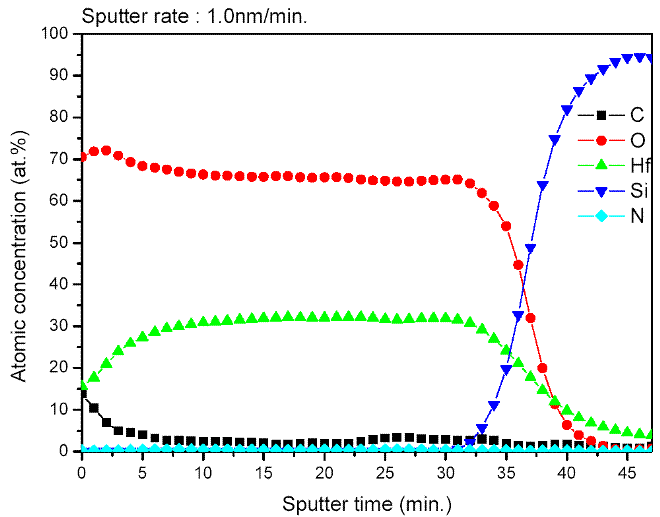
Атомно-слоевое осаждение с воздействием плазмы: Оже-анализ показывает содержание C < 2 %
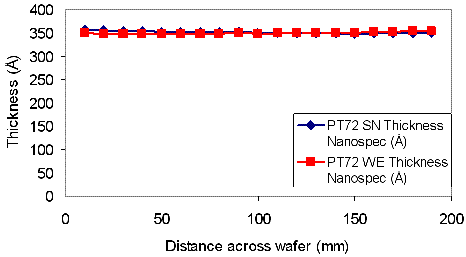
Равномерность толщины по 200мм пластине ± 1.3 %
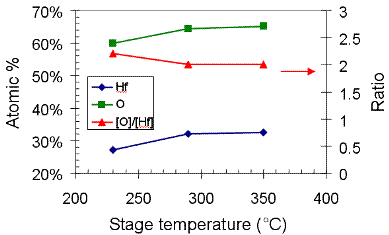
Зависимость стехиометрического состава от температуры процесса. При температуре ниже 290° C (температура подложки 260° C) содержание H значительно возрастает.
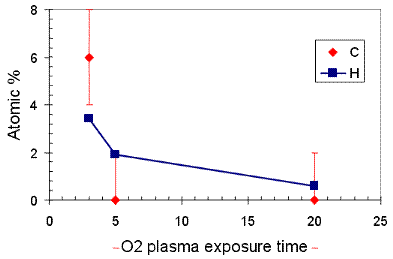
Зависимость содержания H от времени горения О2 плазмы

Зависимость содержания H от температуры процесса