Атомно-слоевое осаждение нитрида алюминия (AlN) с применением удаленного источника плазмы
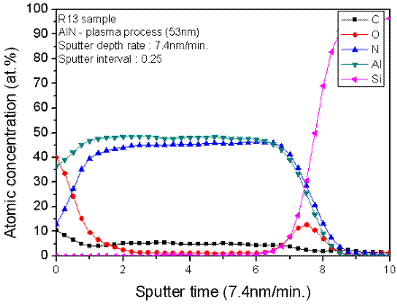
Атомно-эмиссионный анализ показывает стехиометрический состав пленки AlN.
Последующая работа была проделана для снижения содержания углерода в пленке (здесь ~ 6%).
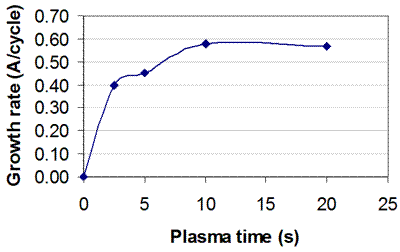
Зависимость роста пленки за цикл от времени горения плазмы.
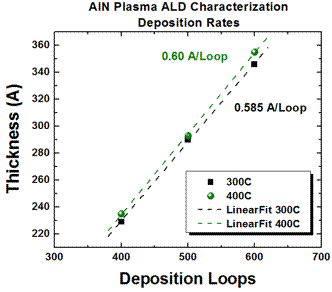
Зависимость толщины пленки от количества циклов осаждения.
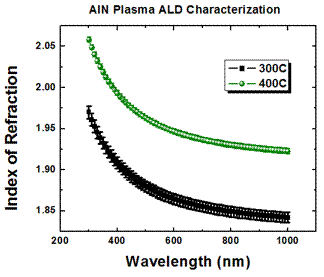
Зависимость коэффициента преломления от длины волны при температурах осаждения 300°C и 400°C.
Технологические особенности осаждения:
- Металлический прекурсор: TMA (триметил алюминия);
- Неметаллический прекурсор: радикалы N и H из смеси газов N2/H2;
- Temperature controlled vapour draw;
- Доза прекурсора контролируется быстродействующей системой подачи газов;
- Процесс широко известен в литературе как неидеальный ALD процесс, т.к. не обладает самоограничевающими свойствами при использовании аммиака (NH3) в качестве термо- или плазмопрекурсора;
- Процесс ALD с использованием удаленной плазмы N2/H2;
- Температура осаждения: 100-400°C;
- Время цикла:
- для 200 мм подложки < 4 c;
- для подложек меньших размеров ~ 3 c;
- 0.58 A/цикл (при 300°C и дозе насыщения) --> 18 A/мин --> более 100 нм/ч (для 200 мм подложки) (быстрее для подложек меньших размеров);
- Равномерность: < ± 0.5 - 2 % (в зависимости от размеров подложки);
- Коэффициент преломления: ~1.86 при 300° C; ~1.94 при 400°C.