Атомно-слоевое осаждение оксида кремния (SiО2) с применением удаленного источника плазмы
Конформное осаждение SiO2 c применением удаленного источника плазмы, аспектное соотношение тренча 30:1.

Атомно-эмиссионный анализ пленки SiO2, осажденной ALD методом.
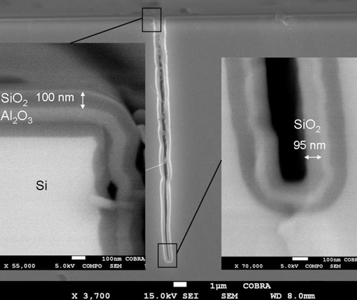
Конформное осаждение SiO2 c применением удаленного источника плазмы, аспектное соотношение тренча 30:1.
Технологические особенности осаждения:
- Прекурсор: BTBAS (либо 3DMAS и 2DEAS);
- Прекурсор в плазме: радикалы О и О2;
- Барботирование при 35оС;
- Доза прекурсора контролируется быстродействующей системой подачи газов;
- Температура осаждения: 100-400°C;
- Время цикла < 9c - для 200 мм подложки, для меньших подложек короче;
- 1.4 A/цикл (при 290°C и дозе насыщения) --> 9 A/мин --> более 56 нм/ч - для 200 мм подложки (быстрее для подложек меньших размеров);
- Равномерность: < ± (1-3) % (в зависимости от размеров подложки);
- Повторяемость < ± 1%;
- Содержание примесей: С<4% - при 400 оС;
- Коэффициент преломления: ~1.42-1.44;
- Соотношение Si:O равно 1:2.
Оборудование: FlexAl & OpAl
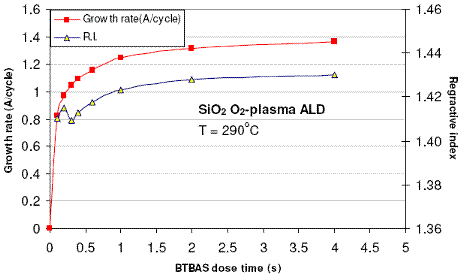 |
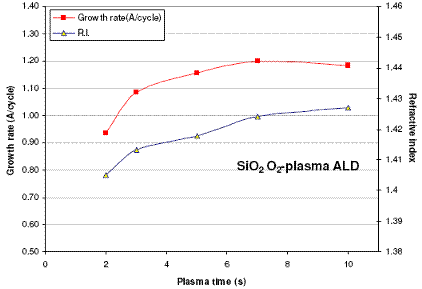 |
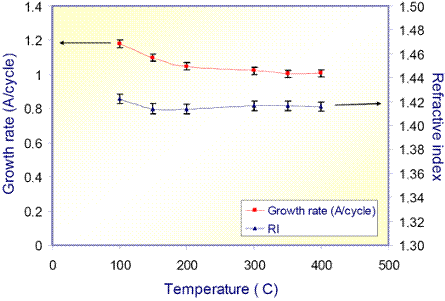 |
|---|---|---|
| Зависимости скорости осаждения пленок и коэффициента преломления от времени воздействия прекурсора (BTBAS). | Зависимости скорости осаждения пленок и коэффициента преломления от времени воздействия плазмы. | Зависимости скорости осаждения пленок и коэффициента преломления от температуры осаждения. |