Глубокое травление Si в PlasmaProEstrelas
Оборудование:
PlasmaProEstrelas с ICP источником и загрузочным шлюзом.
Особенности технологии:
- Реактивное ионное травление с применением источника индуктивно-связанной плазмы;
- Bosch процесс при комнатной температуре;
- Гелиевый поддув под подложку.
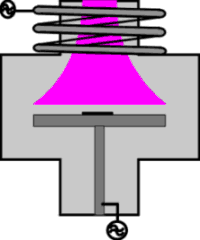
Процесс Bosch-травления кремния может быть оптимизирован по следующим параметрам:
- скорость травления: > 25 мкм/мин (10% открытой площади);
- селективность к фоторезисту: > 250:1;
- селективность к SiO2: > 500:1;
- аспектное соотношение: > 70:1;
- размер боковых раковин (scallop): <10 нм;
- размер выемок (notching): <10 нм (при КНИ технологиях);
- равномерность: +/-3% по 200 мм пластине.
Примеры Bosch-процессов глубокого травления Si, проведенных на PlasmaProEstrelas:
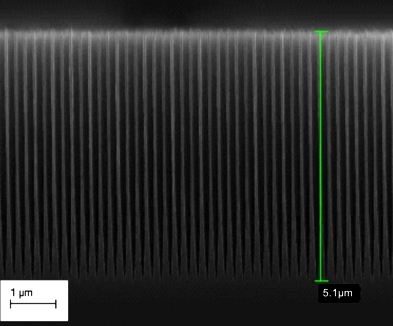 |
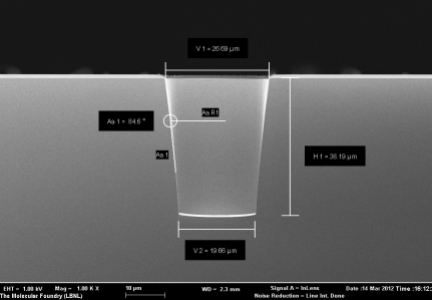 |
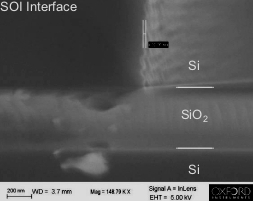 |
|---|---|---|
| Нано-Bosch с шагом 200 нм, аспектное соотношение 45:1 |
конусное переходное отверстие - TSV (криопроцесс) |
Травление КНИ Bosch-процессом |
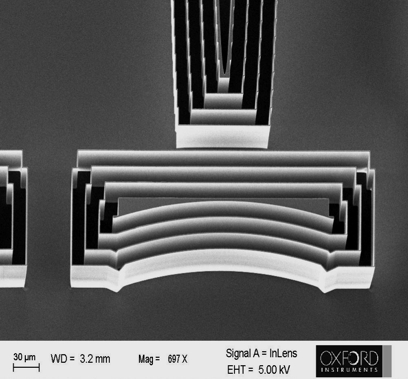 |
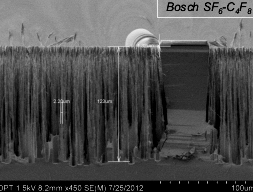 |
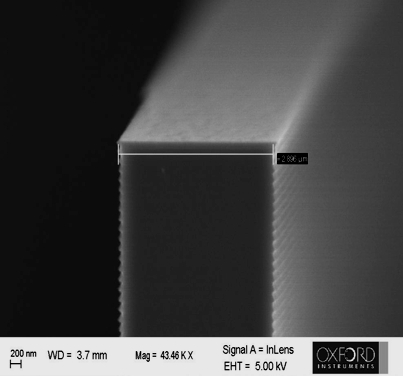 |
| Рентгеновские линзы с функцией компенсации, глубина 75 мкм |
"Черный кремний" с типовым размером 120 мкм (Bosch-процесс) |
Нет подтрава маски, раковины <50нм |
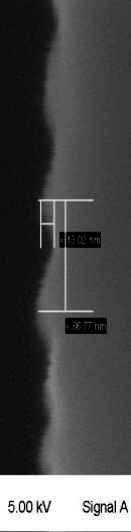
- Глубина скэлопа всего 13 нм;
- Длительный эксперимент (7 недель) по определению стабильности процесса;
- Скорость травления - 6,3 мкм/мин ± 1.6%;
- Профиль - 90о ± 0.18%.
Определение точки окончания процесса травления Si (на SiO2) с помощью оптической эмиссии (для КНИ и TSV):

Травление КНИ для МЭМС <0.25% площади линии SiF и её первая производная.

Красная линия: линия SiF во время травления КНИ.
Оранжевая линия: максимумы линии SiF.
Синяя линия: первая производная от оранжевой линии.