Атомно-слоевое травление Si (atomic layer etching)
В процессе атомно-слоевого травления (ALE) используются 2 самолимитирующихся субпроцесса:
- воздействие на Si поверхность малой контролируемой дозой Cl2;
- удаление с поверхности пластины только слоя SiClx путем бомбардировки низкоэнергетичными ионами.
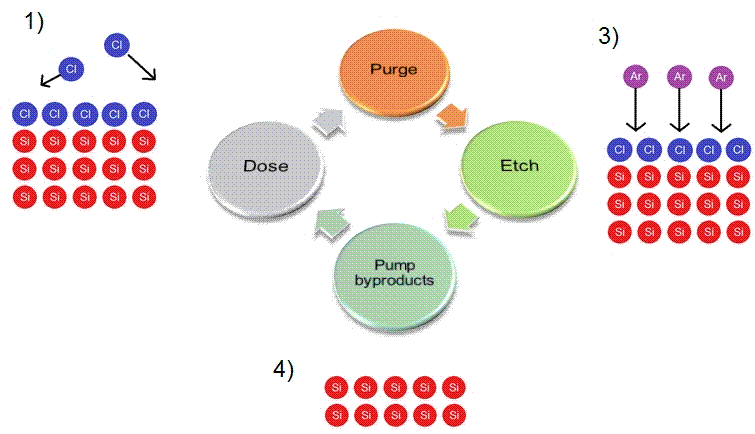
Изображение с СЭМ показывает гладкую поверхность травления.
Скорость травления: 7 А/цикл, до 70 А/мин
Преимущества процесса ALE над процессом обычного сухого травления:
- превосходный контроль глубины для травления нанометровой глубины;
- лучшая селективность к другим слоям;
- очень гладкая поверхность;
- превосходная равномерность;
- существенно меньший эффект зависимости травления от аспектного соотношения;
- слабое повреждение кристалла.
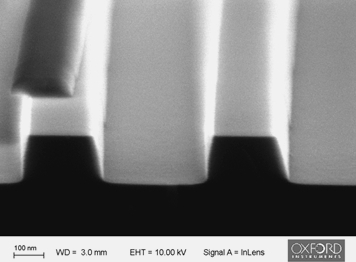
Иллюстрация гладкости стенок и нижней границы тренча
Система для атомно-слоевого травления должна быть оснащена:
- быстрыми PLC контроллерами со скоростью срабатывания 1 мсек;
- контролем дозы вещества с помощью быстрых клапанов, аналогичных тем что стоят на системах атомно-слоевого осаждения;
- высокоточным контролем энергии ионов;
- автоматическое устройство согласования
- низким, хорошо контролируемым источником для организации смещения на подложке и RIE мощности <10 Вт;
- спиральным источником индуктивно-связанной плазмы с электростатическим экраном.