Атомно-слоевое осаждение нитрида титана (TiN) с применением удаленного источника плазмы
Фотография с просвечивающего электронного микроскопа (ТЕМ): Пленка TiN толщиной 110 A, осажденная методом ALD.
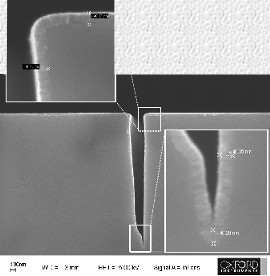
Конформное осаждение пленки TiN на поверхность глубокого тренча с увеличивающимся аспектным соотношением. Равномерная толщина покрытия в 40 нм на всей поверхности.
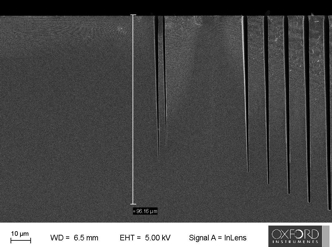
Покрытие TiN толщиной 50 нм, осажденное на поверхность тренча глубиной 100 мкм. Аспектное соотношение 300:1.
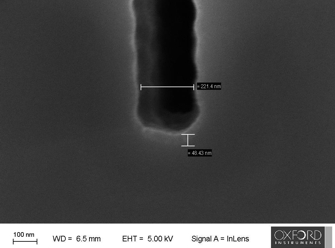
Покрытие TiN толщиной 50 нм на поверхности тренча (шероховатость присутствует из-за того, что травление проходило по технологии Бош-процесса).
Технологические особенности:
- Прекурсор: TiCl4;
- Плазмообразующие газы: N2/H2;
- Temperature controlled vapour draw;
- Доза прекурсора контролируется быстродействующей системой подачи газов;
- Температура осаждения: 100-500°C;
- Время цикла < 12с для пластины диаметром 200 мм (цикл короче для пластин меньшего диаметра ~9 c);
- 0.33 A/цикл (при насыщенной дозе прекурсора);
- 1.65 A/мин, 10 нм/час (для 200 мм подложки).
Результаты:
- Равномерность: ±0.5%;
- Сопротивление < 175 мкОм см (равномерность ±2%);
- Качественный процесс при 350°C (550°C для получения аналогичного покрытия методом термического ALD);
- Содержание Cl < 1%.

Энергорассеивающая рентгеновская спектроскопия (EDS) пленки TiN расположенной внизу тренча Si пластины.

Зависимость толщины пленки наносящийся за цикл от концентрации прекурсора TiCl4 (подложка 200 мм).
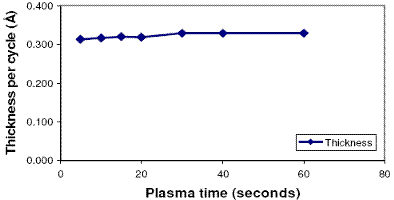
Рост пленки за цикл в зависимости от времени горения плазмы.
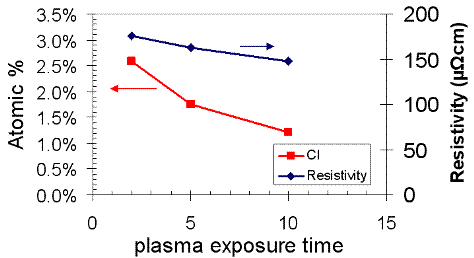
Зависимость содержания Cl в пленке и её сопротивления от времени горения плазмы. Чем больше время горения разряда, тем выше качество пленки.
Схематическое изображение самоограничивающихся этапов нанесения пленки нитрида титана (TiN):
| Шаг 1. Реакция с металлическим прекурсором | Шаг 2. Продувка | Шаг 3. Реакция с неметаллическим прекурсором | Шаг 4. Продувка |
|---|---|---|---|
 |
 |
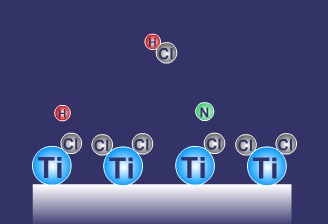 |
 |
 |
|  |
|