Химическое осаждение SiN с использованием источника индуктивно-связанной плазмы (ICP-PECVD)
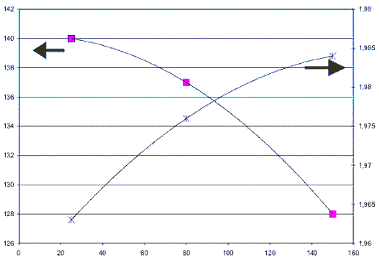
Лаборатория OIPT: зависимость скорости осаждения (левая шкала) и коэффициента преломления (правая шкала) от температуры (oC) осаждения SiN.
Технологические особенности:
- осаждение с помощью источника индуктивно-связанной плазмы (частота 2 или 13 МГц) и ВЧ управляемого нижнего электрода.
Результаты:
- скорость: 5-100 нм/мин;
- рабочая температура: 20 - 100°C;
- хорошая равномерность по пластине размером до 150 мм;
- процесс проходит при низком давлении (<10 мТорр) для получения улучшенных электрических характеристик;
- процесс идет без использования аммиака (NH3);
- пробойное напряжение > 4 МВ/см;
- коэффициент преломления контролируется в пределах от 1.77 до 2.54;
- внутренние напряжения: < 100 MPa;
- для изготовления мембран внутренние напряжения в пленках могут регулироваться в пределах от -25 МПа (сжимающие) до 25 Мпа (растягивающие - без смещения на подложке);
- на спектре пропускания в ИК области спектра не обнаружено пиков поглощения соответствующим N-H группам.
Дизайн ICP источника
Все источники OIPT (индуктивно-связанной плазмы или высокочастотные) проектируются с наличием электростатических экранов, для того, чтобы быть уверенным в чистоте замагниченной плазмы, без емкостной составляющей. Поэтому загрязнения от боковых стенок и бомбардировка подложки высокоэнергетичными ионами исключена.
Расстояние между подложкой и источником плазмы
Расстояние может сильно разниться для оптимального контроля параметров процесса.