Травление в индуктивно-связанной плазме (ICP Etch)
Технологические особенности травления в индуктивно-связанной плазме:
- Высокая скорость травления достигается высокой плотностью ионов (>1011 cm3) и радикалов;
- Рабочее давление: 1-100 мТорр;
- Контроль селективности и уровня повреждений достигается низким уровнем ионных энергий;
- Отдельные RF и ICP генераторы обеспечивают раздельный контроль энергии ионов и плотности ионов;
- Низкое рабочее давление и высокая плотность заряженных частиц позволяют контролировать профиль поверхности;
- Химическое и ионно-стимулированное травление;
- Может работать в режиме реактивного ионного травления (RIE) с низкоскоростным травлением структур;
- Может работать в режиме химическое осаждение из газовой фазы (ICP-CVD);
- Высокопроизводительный откачной пост обеспечивает большие объемы прокачки рабочего газа, для увеличения скорости травления;
- Электростатический экран устраняет емкостные наводки, уменьшая уровень повреждений подложки;
- Прижим пластин и гелиевый поддув под пластины, обеспечивает отличный температурный контроль с широким диапазоном.
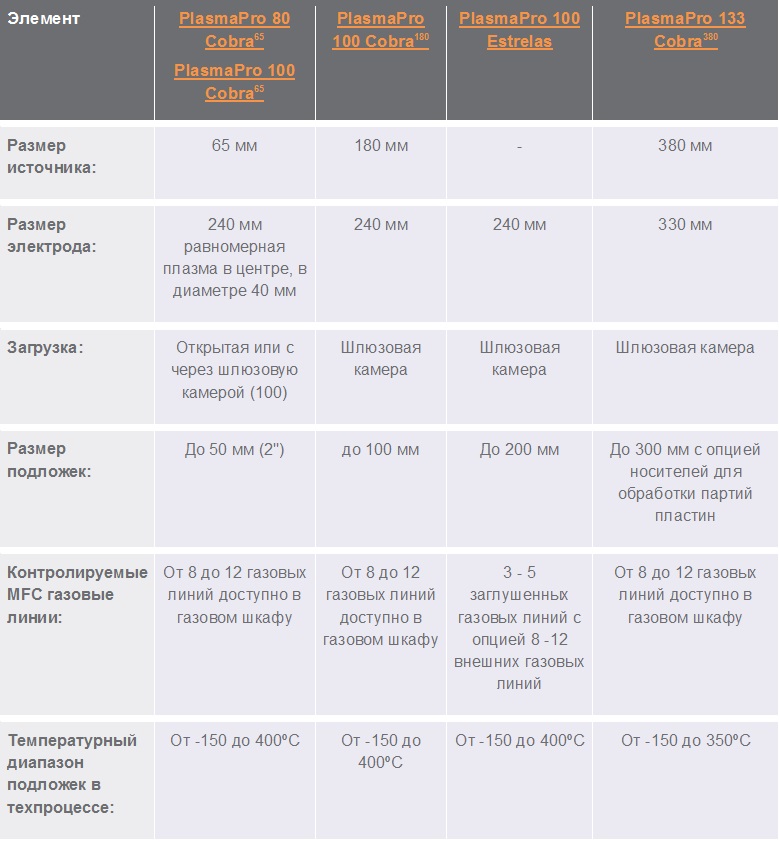
- Травление A3B5 с низким уровнем повреждения поверхности;
- Высокоскоростное травление кремния с хорошей селективностью к маске для МЭМС.
Машины OIPT, в которых реализована эта технология: PlasmaPro100, PlasmaPro80, PlasmaProEstrela.