Реактивное ионное травление InP с применением ICP источника
Оборудование: PlasmaPro100
Особенности технологии:
Рабочие газы: CH4/H2/Cl2 или CH4/H2
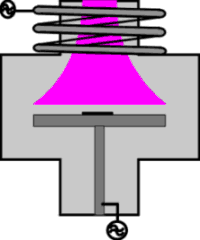
Результаты:
- Процессы с применением хлорной химии:

Процесс с рабочими газами CH4/H2/Cl2- Скорость травления > 1 мкм/мин;
- Cелективность к SiO2 маске (10-25):1.
- Процессы в безхлорной химии:
- Cкорость травления ~ 200 нм/мин
- Cелективность к фоторезисту > 10:1 (селективность InGaAs или InGaAsP к PR 1:1)
 |
 |
 |
 |
| газы - CH4/H2, маска - PR, глубина травления - 2 мкм |
маска - SiO2, глубина травления - 3 мкм |
маска - Al2O3 (не удалена) глубина травления - 15 мкм |
маска - Al2O3 (не удалена) глубина травления - 8 мкм |
