Реактивное ионное травление SiO2 с AR 5:1
Лаборатория OIPT: глубина тренчей 1 мкм, ширина линий 230 нм, впадин — 300 нм. PR удален в O2 плазме.
Оборудование:
Особенности технологии:
Результаты:
- скорость травления: 30-50 нм/мин, маска - фоторезист, 100 нм/мин при наличие гелиевого поддува (выше при использовании твердых масок);
- селективность к PR маске: (3-10):1;
- анизотропный профиль;
- гладкие боковые стенки;
- селективность к нижнему слою Si: (5-12):1;
- равномерность +/- 4% по 6 дюймовой пластине;
- повторяемость по большой выборке +/- 3.5.
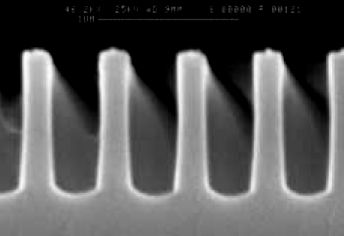 |
 |
 |
|---|---|---|
| Глубина тренчей 1 мкм, ширина линий 230 нм, впадин - 300 нм. PR удален в O2 плазме | Глубина травления SiO2 - 8 мкм | Глубина тренчей 1 мкм, ширина отверстия под контактную площадку 400 нм. PR удален в O2 плазме |
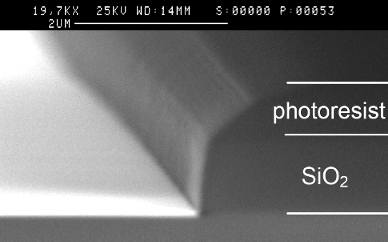 |
 |
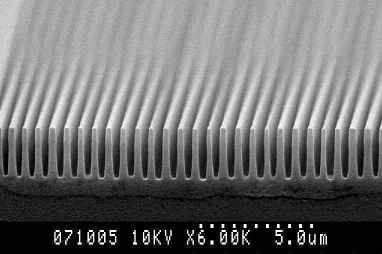 |
| Анизотропное травление оксида кремния на глубину 1 мкм, фоторезист не удален | Контролируемый наклон стенок, например, в случае сквозного травления | Травление на 4 мкм, аспектное соотношение 5:1, селективность к фоторезисту (UVIIHS08) 5:1 |