Криотравление Si c НЧ смещением и применением ICP источника плазмы
Оборудование: PlasmaPro100
Особенности технологии:
- Реактивное ионное травление с применением источника индуктивно-связанной плазмы;
- Низкочастотное (НЧ) смещение на подложке;
- Гелиевый поддув под подложку.
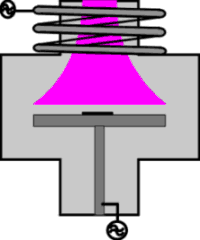
Результаты:
Профиль получается с положительным наклоном ("перепассивация") в случае более крупной топологии на структуре и некоторого избытка кислорода, либо образуется небольшой подтрав в случае мелкой топологии и недостатка кислорода на боковых стенках.
С добавлением НЧ смещения на подложку равномерность профиля тренчей разных размеров может быть улучшена.
НЧ смещение позволяет расширить диапазон энергий ионов, приходящих на подложку, и избежать их фокусирования в центре тренча. Что обеспечивает качественное травление как широких, так и узких тренчей.
Однако увеличение ионной бомбардировки приводит к ухудшению селективности с 20:1 до ~7:1
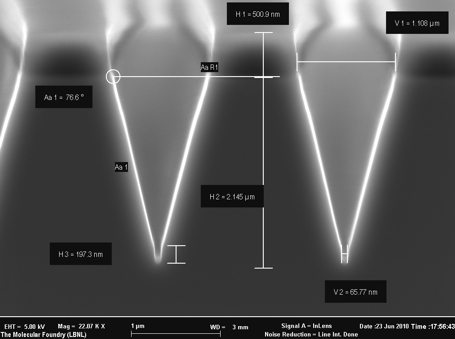 |
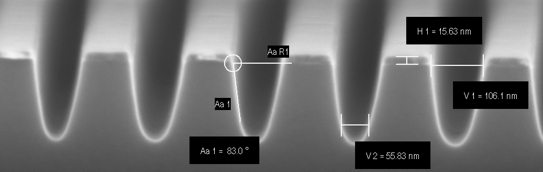 |
|---|---|
| ↑ техпроцесс без НЧ смещения на подложке ↓ техпроцесс с НЧ смещения на подложке |
↑ техпроцесс без НЧ смещения на подложке ↓ техпроцесс с НЧ смещения на подложке |
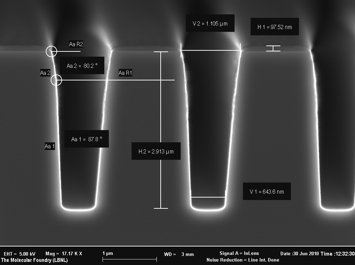 |
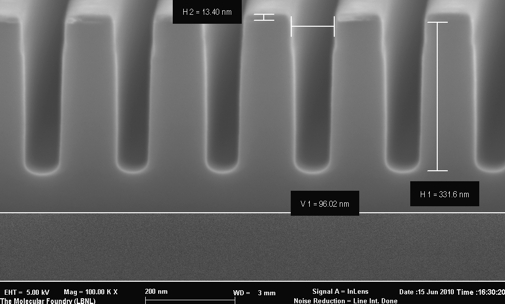 |