Высокоскоростное травление SiC с применением ICP источника
Оборудование: PlasmaPro100
Особенности технологии:
Реактивное анизотропное ионное травление SiC с применением источника индуктивно связанной плазмы (ICP), процесс основан на фторной химии.
Результаты:
- Рейнско-Вестфальского технического университета Ахена:
Пример травления гексагонального карбида кремния (6H-SiC) для UMOS-структур с закругленным профилем кромок. Максимальная скорость травления 248 нм/мин, глубина - 3,3 мкм. Закругленные кромки созданы с помощью изотропно/анизотропно структурированной маски SiO2.
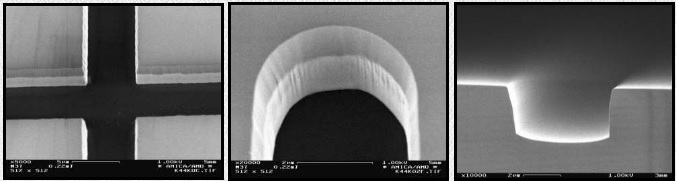
Фото СЭМ протравленной структуры SiC из Рейнско-Вестфальского технического университета Ахена. - Лаборатория OIPT:
- скорость травления 200 - 400 нм/мин;
- маски: Ni, Al или ITO;
- селективность: (5-40):1;
- селективность фоторезисту (SU-8): >0.5:1;
- равномерность по 100 мм пластине <+/-3%.
 |
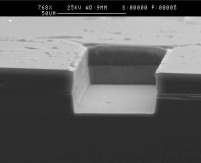 |
|---|---|
| Анизотропное травление SiC с применением ICP источника на глубину 2 мкм. Ni маска не удалена. | Анизотропное травление SiC с применением ICP источника на глубину 15 мкм. Маска - SU-8, профиль 85о, скорость травления - 220 нм/мин. |