Химическое осаждение поликристаллического кремния (poly-Si) при низком давлении (LPCVD)
Оборудование: PlasmaProSystem 100/133
Технологические особенности:
- реактор с двумя параллельными электродами;
- газовый душ для равномерного осаждения;
- основной реактивный газ - SiH4.
Результаты:
- Температура процесса LPCVD 650оС;
-
Скорость осаждения : 2 нм/мин (20 нм/мин для PECVD);
- Равномерность: +/- 5% для 100 мм подложки.
Рентгеновский анализ и спектры Рамана демонстрируют кристаллическую структуру осажденных Si пленок: размер зерна > 100нм, степень кристалличности >80%.
Пленки поликремния растут преимущественно вдоль ориентации <1 1 0>, ориентация и кристаллизация пленок происходит вдоль ориентации <1 1 1>.
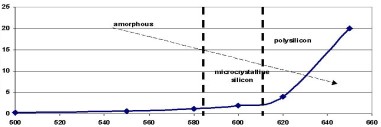
Зависимость скорости осаждения Si при LPCVD от температуры (580-620оС - переходная зона).