Атомно-слоевое осаждение оксида титана (TiO2) с применением удаленного источника плазмы
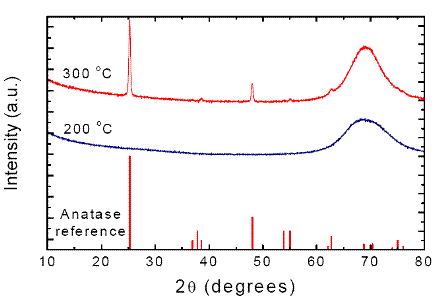
Изменяя температуру осаждения можно изменить степень кристалличности пленки TiO2.
Рентгено-дифракционные спектры показывают как меняется структура пленки TiO2 от аморфной к анатазной при изменении температуры от 200° до 300°C.
Размытый максимум - это кристаллический кремний.
Особенности процесса и результаты:
- Прекурсор: Изопропоксид титана - TTIP = Ti(OC3H7)4;
 ;
;- плазмообразующий газ: O2;
- способ доставки: барботирование;
- доза прекурсора контролируется быстродействующей системой подачи газов;
- температура осаждения: 25° - 300°C;
- время цикла < 10 сек для 200 мм подложки (короче для подложек меньшего размера ~ 7 c);
- скорость роста: 0.47 A/цикл (при дозе насыщения для аморфных пленок), 2.8 A/мин, 17 нм/час (для 200 мм подложки, быстрее для малых подложек);
- равномерность: ± 2 %
- содержание C и H < предела определения (2%);
- коэффициент преломления - 2.4;
- Ti:O = 1 : 2 по RBS (резерфордовское обратное рассеяние);
- плотность 3.8 г/см3;
- запрещенная энергетическая зона 3.5 эВ (при 200°C).

Данные Эйндховенского университета:
Осаждение при комнатной температуре: скорость - 0,4-0,55 А/цикл (измерено в процессе роста с помощью эллипсометра)

RBS анализ 66 нм пленки TiOx на структуру Si/SiO2
Ti:O = 1:1, без C, без H,
Si частично покрыт маской
плотность пленки TiO2 - 3.8 г/см3 (для сравнения плотность массивного материала TiO2 - 4.2 г/cм3)