Плазмостимулируемое атомно-слоевое осаждение нитрида ниобия (NbN) для электродов затвора
Скорость осаждения и равномерность (по 150 мм пластине) в зависимости от времени воздействия прекурсора (TBTMEN).
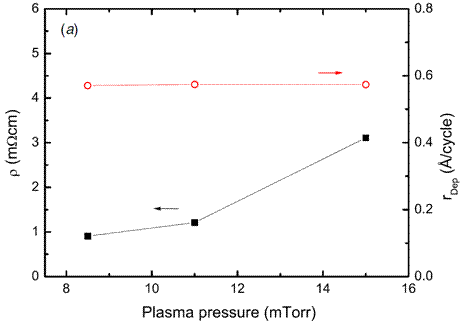
Зависимость скорости осаждения и удельного сопротивления от рабочего давления. Понижение рабочего давления дает уменьшение удельного сопротивления.
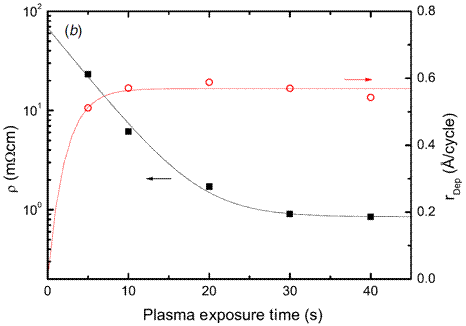
Зависимость скорости осаждения и удельного сопротивления от времени горения плазмы.
По графику можно сделать выбор в пользу времени горения разряда - 30 с. Увеличения времени не изменит скорость осаждения, но может улучшить качество пленок NbN.
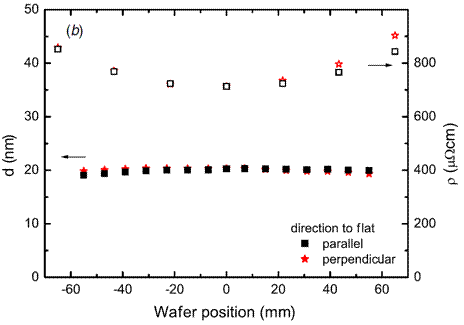
Иллюстрация равномерности толщины и поверхностного сопротивления пленок NbN по 150 мм пластине (Пленка осаждалась за 450 циклов при Р=8,5 мТорр).
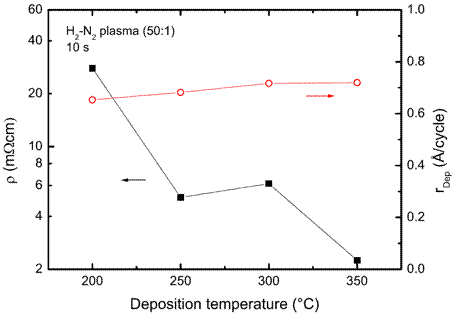
Зависимость скорости осаждения и удельного сопротивления от температуры осаждения.
Скорость осаждения не зависит от температуры, т.к. при 350 оС процесс плазмохимического осаждения(CVD) еще не идет.
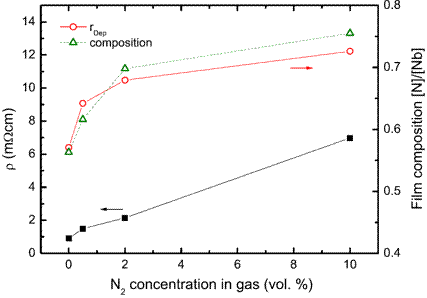
Зависимость удельного сопротивления,состава пленки и скорости осаждения от концентрации азота и водорода (состав пленки изучен рентгеновской фотоэмиссионной спектроскопией).
Метод плазмостимулированного атомно-слоевого осаждения (PEALD) нитрида ниобия часто сравнивают с химическим осаждением из паров металлоорганических соединений (MOCVD). Пленки, выращенные методом PEALD, обеспечивают более высокое качество поверхности (низкое плотность дефектов и шероховатость) и значительно более низкую температуры осаждения.
Технологические особенности и результаты:
- Металлический прекурсор: TBTMEN;
- Метод доставки прекурсора: барботирование с аргоном;
- Неметаллический прекурсор: H2/N2 плазма;
- Скорость осаждения: 0,65 А/цикл --> 0.2-0.6 нм/мин --> 12-36 нм/час;
- Время цикла: 20-60 с.
Преимущества использования источника удаленной плазмы:
- При использовании удаленной плазмы отсутствует контакт между подложкой и разрядом;
- Плазма разбивает молекулы и активирует получившиеся радикалы, которые полезны для процесса роста пленки;
- Активные радикалы очищают подложку от примесей, приводят к более чистым осаждающимся покрытиям и снижают температуру процесса.
В системах OIPT процесс ALD может быть выполнен с использованием:
- только термического механизма;
- ассистирования озоном;
- ассистирования удаленной плазмой без изменения конфигурации оборудования.
Многошаговый процесс с использованием всех этих технологий может быть применен в случае необходимости.