Реактивное ионное травление InP/InGaAsP (с ICP) для волноводов
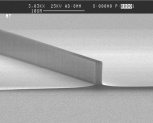 |
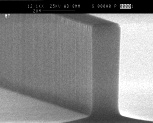 |
 |
 |
| лаборатория OIPT: глубина травления структуры InP/ InGaAsP 10 мкм
|
лаборатория OIPT: глубина травления структуры InP/ InGaAsP 5 мкм
|
лаборатория OIPT: глубина травления структуры InP/ InGaAsP 5 мкм
|
лаборатория OIPT: глубина травления структуры InP/ InGaAsP 6 мкм
|
Сравнение:
Процесс с CH4/H2/Cl2 химией не нуждается в прижимной пластине или нагреваемом электроде, что упрощает оборудование, и позволяет обрабатывать куски пластин или несколько пластин разом.
Процесс с Cl2/N2 химией предлагает более "чистую" альтернативу, но требует подогреваемый электрод и прижимную пластину, и реализуем только на целых пластинах (или на кусках, приклеенных к держателю пластин). Процесс с химией HBr позволяет использовать фоторезист в качестве маски.