Реактивное ионное травление InP (с ICP) для фотонных кристаллов
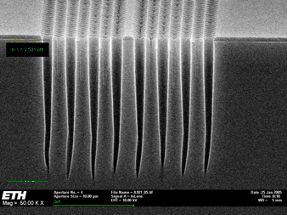
- высокое аспектное соотношение при травлении InP;
- высокотемпературный процесс с рабочим газом Cl2;
- глубина 3,5 мкм;
- диаметр 0,27 мкм;
- 200 нм InP/ 400 нм InGaAsP/ InP-подложка;
- скорость травления 1.75 мкм/мин.
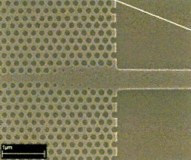
Photonic crystal-to-ridge waveguide taper.

- высокое аспектное соотношение при травлении InP;
- высокотемпературный процесс с рабочим газом Cl2;
- глубина 2,9 мкм;
- диаметр 0,18 мкм;
- 200 нм InP/ 400 нм InGaAsP/ InP-подложка;
- скорость травления 1.75 мкм/мин;
- аспектное соотношение 16:1.

- высокое аспектное соотношение при травлении InP;
- процесс проходит при комнатной температуре с рабочими газами CH4/Cl2;
- глубина 4 мкм;
- диаметр 0,56 мкм;
- скорость травления 0.5 мкм/мин.
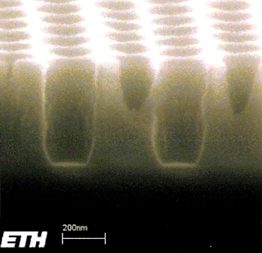
Анизотропное травление маски (реактивное травление SiN на PlasmaPro80 RIE, осаждение SiN наPlasmaPro80 PECVD).

Волновод и резонатор.
Процесс (Реактивное ионное травление):
- с использованием источника индуктивно связанной плазмы (ICP Source) с частотой 13.56 МГц;
- управляемый ВЧ электрод подложки.
Результаты:
- равномерность: +/-2.5 % (2“);
- анизотропный профиль;
- гладкие боковые стенки.
С благодарностью к P Strasser, R Wuest, Dr F Robin (ETH Zurich, Швейцария).
