Атомно-слоевое осаждение нитрида гафния (HfN) с применением удаленного источника плазмы
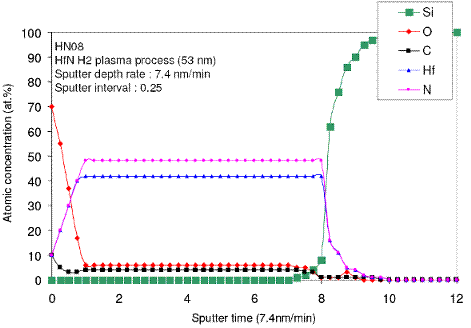
Атомно-эмиссионная спектроскопия пленки HfN.
Особенности технологии:
- TEMAH (тетроэтилметиламиногафний) нагревается до 70°C и подается методом барботирования;
- Неметаллические прекурсоры: NH3 или N2/H2;
- Доза прекурсора контролируется быстродействующей системой подачи газов;
- Скорость осаждения 0.9 A/цикл.
Преимущества использования источника удаленной плазмы:
- При использовании удаленной плазмы отсутствует контакт между подложкой и разрядом;
- Плазма разбивает молекулы и активирует получившиеся радикалы, которые полезны для процесса роста пленки;
- Активные радикалы очищают подложку от примесей, приводят к более чистым осаждающимся покрытиям и снижают температуру процесса.
В системах OIPT процесс ALD может быть выполнен с использованием:
- только термического механизма;
- ассистирования озоном;
- ассистирования удаленной плазмой; без изменения конфигурации оборудования.
Многошаговый процесс с использованием всех этих технологий может быть применен в случае необходимости.
