Атомно-слоевое осаждение нитрида галия (GaN) с применением удаленного источника плазмы
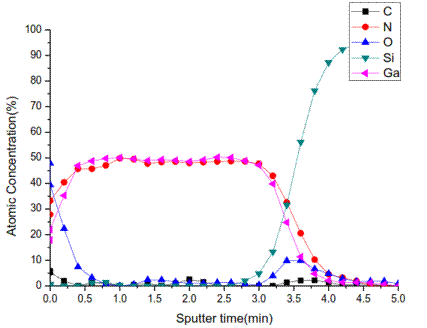
Атомно-эмиссионная спектроскопия пленки GaN толщиной 65 нм.
Технологические особенности:
- Металлический прекурсор: триэтил галия (TEGa);
- Неметаллический прекурсор: удаленная плазма газов N2/H2;
- Temperature controlled vapour draw;
- Доза прекурсора контролируется быстродействующей системой подачи газов;
- Температура осаждения: 150-350°C.
Длительное воздействие плазмы необходимо для уменьшения содержания кислорода в пленке, и, ввиду этого, увеличения коэффициента преломления. И хотя полупериод процесса равен 5с, более длительное время необходимо для достижения значений содержания примесей, указанных ниже.
Результаты:
- Равномерность: < ± 0.5 - 2 % (в зависимости от размера подложки);
- Содержание примесей: C < 3% , O < 3%;
- Коэффициент преломления: 2.27;
- Скорость осаждения: более 1.75 A/мин (более 10 нм/час) для 100 мм подложки (скорость больше для малых подложек).
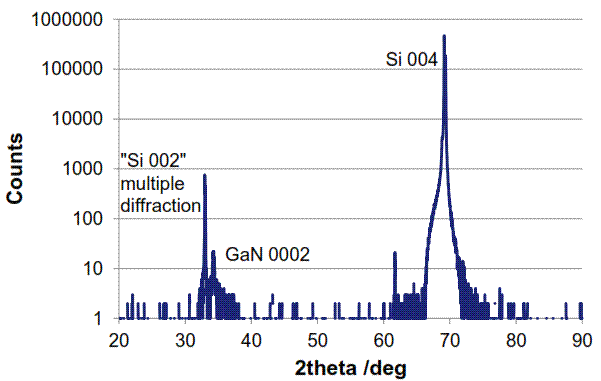
Дифракционный рентгеновский анализ (XRD) показывает небольшой пик присущий GaN [0002].